Gelest offers precursor materials for metallization applications derived from Group III & IV elements (Si, Al, Ti, Ta, W, In, Sb, Ge) used to create conductive coatings on silicon, germanium, silicon carbide, sapphire, and plastic substrates. These precursors are suitable for various deposition techniques such as ALD, CVD, MOCVD, and PECVD.
Metallization
| SKU | Image | Name |
|---|---|---|
| AKT890 |

|
TUNGSTEN(V) ETHOXIDE, tech |
| AKC252.8 |

|
COPPER(I)/(II) HEXAFLUORO-2,4-PENTANEDIONATE - VINYLTRIMETHYLSILANE COMPLEX |
| AKC262 |
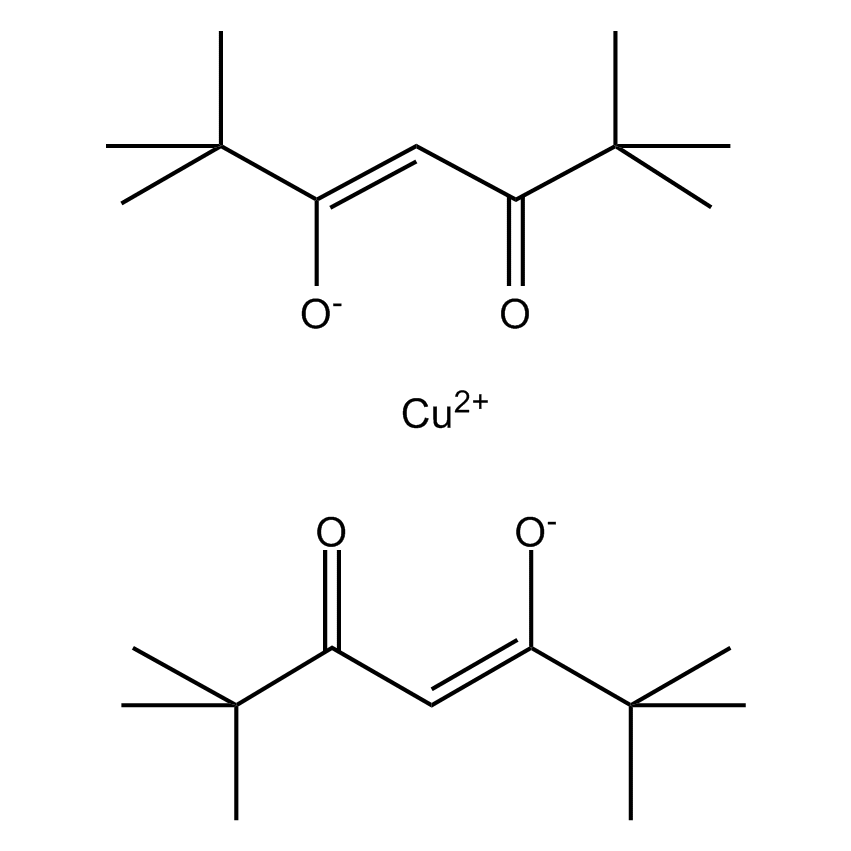
|
COPPER(II) 2,2,6,6-TETRAMETHYL-3,5-HEPTANEDIONATE |
| OMAL005 |

|
ALANE-DIMETHYLETHYLAMINE COMPLEX |
| OMAL008 |
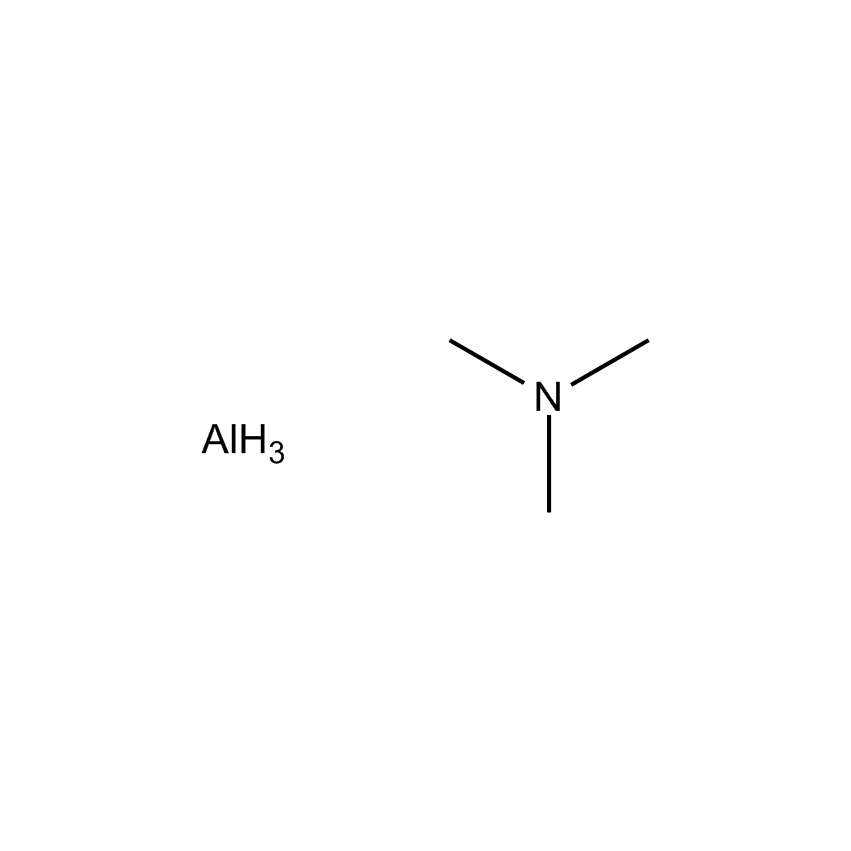
|
ALANE-TRIMETHYLAMINE COMPLEX |
| OMAS080 |

|
TRIS(DIMETHYLAMINO)ARSINE |
| OMRU027 |

|
DIETHYLRUTHENOCENE |
Silicon sources such as monochlorosilane, dichlorosilane, 1MS, 2MS, 3MS, 4MS and germanium sources such as germane, t-butylgermane, germanium tetrachloride and other analogs are used in production of strained silicon using metal organic vapor phase epitaxy (MOVPE) to improve chip performance and lower energy consumption.
SiGe Precursors
Group IV material are used to reduce electromigration and other effects that Cu and Al have on Si and SiO2 insulator properties and adhesion, while reducing metal corrosion. Typical deposition methods include PVD, CVD, and MOCVD.
Cobalt Barrier Layers
Tantalum Barrier Layers
Titanium Barrier Layers
| SKU | Image | Name |
|---|---|---|
| OMTI083 |

|
TITANIUM TETRAKIS(ETHYLMETHYLAMIDE), 99+% |
Gelest has developed patented “chloride-free” chemical process technology to commercially produce Group IV materials for use as gate dielectrics and ILD (inter-layer dielectrics). Typical Group IV materials for gate dielectrics are compounds of Hf, Zr, and rare earths such as Ce, La, Pr. Typical ILD precursors are Si based. In addition, Si-based materials will play a critical role in future generations of porous dielectric materials that will require improved adhesion, mechanical and thermal properties. Porous ULK dielectrics will require the use of CAPS.
Hafnium Gate Dielectrics
Thin Film Inter-Layer Dielectrics
Pore Sealing & CAPS Inter-Layer Dielectrics
Group IV materials can be applied neat or in solution via conventional lithography techniques to form SAMs. SAM is a layer of amphiphilic molecules created by the chemisorption onto a metal oxide, precious metal surface, plastic, or nanoparticle substrates, followed by the 2-dimensional alignment of hydrophobic groups to form a structures single monolayer. The surface can be selectively modified to achieve the desired antisticktion, mechanical, and chemical properties for microelectromechanical systems (MEMS) and nanoelectromechanical systems (NEMS).
Metal Oxides- MEMS, NEMS, SAMs
| SKU | Image | Name |
|---|---|---|
| SIA0200.0 |

|
(3-ACRYLOXYPROPYL)TRIMETHOXYSILANE, 96% |
| SIA0540.0 |

|
ALLYLTRIMETHOXYSILANE |
| SIA0591.0 |

|
N-(2-AMINOETHYL)-3-AMINOPROPYLTRIMETHOXYSILANE, tech |
| SIB0991.0 |

|
(5-BICYCLO[2.2.1]HEPT-2-ENYL)TRICHLOROSILANE, tech, endo/exo isomers |
| SIH5841.0 |

|
(HEPTADECAFLUORO-1,1,2,2-TETRAHYDRODECYL)TRICHLOROSILANE |
| SIM6476.0 |

|
3-MERCAPTOPROPYLTRIMETHOXYSILANE |
| SIM6492.7 |

|
3-[METHOXY(POLYETHYLENEOXY)6-9]PROPYLTRIMETHOXYSILANE, tech |
| SIT8174.0 |

|
(TRIDECAFLUORO-1,1,2,2-TETRAHYDROOCTYL)TRICHLOROSILANE |
| SIT8185.3 |

|
TRIETHOXYSILYLBUTYRALDEHYDE, tech |
Volatile Carbosilanes and Higher Polysilanes – the preeminent precursors for:
- Amorphous silicon
- SiCO:H films for low-k, barrier layers and etch-stop
- Silicon carbide films and buffer layers
- ALD promoted patterning and seed layers
- Carbon-doped (tensile-strained) silicon
- Silicon carbonitride passivation
Volatile Higher Silanes
| SKU | Image | Name |
|---|---|---|
| SII6463.4 |

|
ISOTETRASILANE |
| SIN6597.07 |

|
NEOPENTASILANE |
| SIT7880.0 |

|
n-TETRASILANE |
| SIT8709.6 |

|
TRISILANE |

















































